 |
中文名:椭圆偏振光谱仪-椭偏仪 |
英文名:Ellipsometer |
仪器型号:RC2 |
设备分类:测试设备 |
房间:D111 |
负责人:许 蔚/叶倩玉 |
生产厂家:
美国J. A. WOOLLAM公司
仪器介绍:
椭偏仪是一种探测薄膜厚度、光学常数以及材料微结构的光学测量仪器。已知入射光的偏振态,偏振光在样品表面被反射,测量得到反射光的偏振态、幅度、相位,拟合得出材料的折射率和消光系数等光学常数信息。可测的样品包括大块材料、薄膜以及在平面基底上生长或沉积的多层结构。由于与样品非接触,对样品没有破坏并且也不需要真空,因此是一种应用非常广泛的测量设备,应用领域包括半导体、电子通讯、数据存储、光学镀膜、科研以及生物医药等;
主要功能:
1)测量对象包括金属、半导体、介电材料、有机高分子聚合物、绝缘体、磁性材料、各项同性和各向异性材料等,
2) 椭偏仪RC2能够进行薄膜材料的厚度分析和各种光电材料的光学常数分析(折射率n和消光系数k);
技术指标:
光谱范围:210nm-2500nm;微光斑直径:150μm;入射角度:45度-90度;自动变角,自动俯仰,自动样品台,样品台直径:200mm。
参数测试准确性:在直射状态下,测量光束Psi=45°±0.03° ,Delta=0°±0.08°;退偏振:0%±0.5%;膜厚重复性优于0.005nm(30次SiO2厚度测量的标准偏差,样品为约25nm热生长SiO2的硅片);15个归一化穆勒矩阵元。
注意事项:
1.确保样品上下表面平整,确保被测表面光滑,测试时能有反射光束被接收;
2.确保被测区域面积大于5mm2;
3.多层膜结构测量时,需提供基底和层层递进的每个样品模型;
4.金属膜厚度测量不能超过30nm;
5.非透明衬底上生长的金属膜测量时,需提供中间膜层300-1000nm热氧SiO2 的样片;
价格:
校内:350元/小时
校外:470元/小时
单位预约时间:30(单位:分钟)
设备上线时间:2023.6.16
状态:正常
其它细节图/成品图:
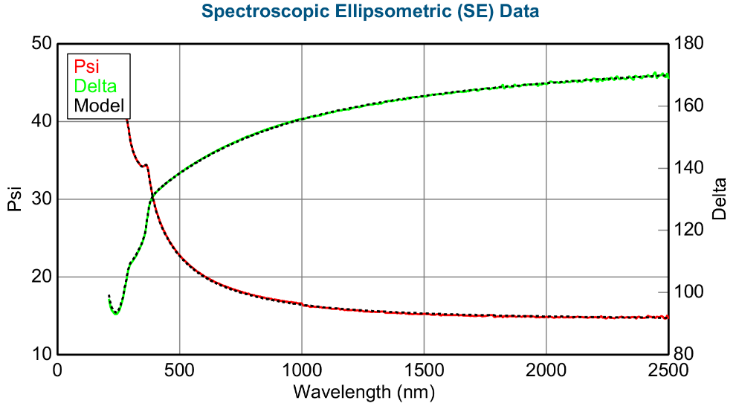

设备大图:
