(1)此文档根据日常咨询的问题整理,如有疑问,可咨询老师和当天刻蚀区助管。
(2)设备异常情况及时联系联系助管和老师,严禁私自操作,助管的联系方式在老三五刻蚀设备旁边。
1刻蚀设备选择
为了避免不同刻蚀材料的交叉污染,将设备刻蚀材料分类如下表
老三五ICP |
InP;GaAs;Cr;Al2O3;TiO2;SiO2 |
新三五ICP |
InP;GaAs;AlN |
Si-ICP |
Si;SiO2;深Si |
NLD |
LiNbO3;SOI的浅Si刻蚀 |
新RIE SENTECH |
SiO2;InP |
旧RIE |
Pt; Cr |
2刻蚀程序的关键参数和指标
做好相关工艺参数记录,设备上会有一些调试好的刻蚀程序可供参考
(1)刻蚀时间
(2)气体种类,流量,
(3)ICP功率,RF功率,
(4)腔压
(5) 背冷He流量
(6)Bias自偏压
3刻蚀工艺指标
3.1刻蚀速率
影响因素有样品材料,刻蚀图形密度,大小。建议准备实验片进行刻蚀速率标定。
测试方法,去除掩膜后测量刻蚀的材料深度
3.2刻蚀选择比
掩膜和材料的刻蚀速率,
测试方法:
1刻蚀前台阶仪测量掩膜厚度
2刻蚀后测量掩膜和刻蚀的材料深度
3去除掩膜后测量刻蚀的材料深度
4刻蚀角度和粗糙度
5刻蚀的侧壁和底部的夹角
6测试方法,刻蚀后通过解理将刻蚀截面暴露出来,通过电镜可测量刻蚀侧壁角度和粗糙度
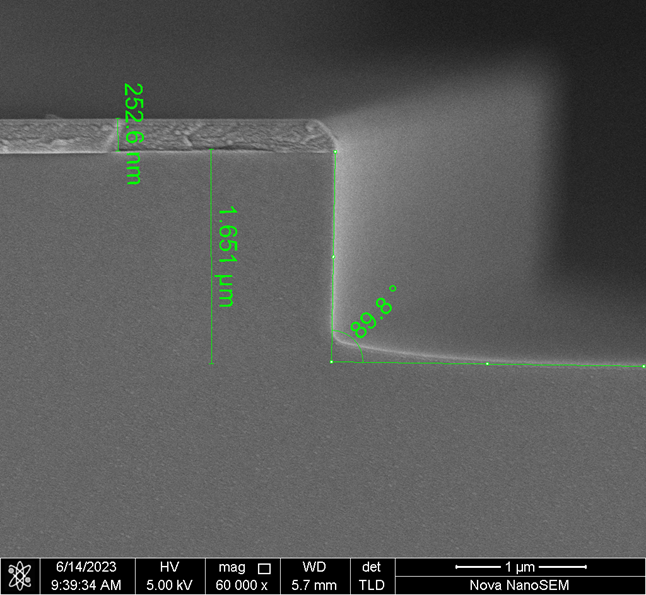
4刻蚀工艺操作
(1)预约系统预约设备,刻蚀设备登记刻蚀材料,样品数量;预约的时间包含刻蚀时间和洗腔时间。
(2)衬底盘清理,无尘布,酒精擦拭托盘正面及背面然后氮气枪吹干。擦拭正面减少刻蚀产物累积,背面是为了避免因为脏污导致Heflow异常影响散热,或者硅油影响下电极偏压。
平台采用的4寸,无切边,1000μm厚的硅片。刻蚀较多的课题组可以自备硅片以避免交叉污染,使用后自己保存。
(3)刻蚀时间需关注刻蚀程序关键参数,反射功率,偏压,Heflow是否正常。
公用程序 关键参数禁止修改保存;反射功率过大,一般程序会自动终止;偏压变化较大可能是腔体较脏,影响刻蚀速率;Heflow过大或者过小都会导致散热下降;
(4)刻蚀完成后,将衬底盘擦拭干净后,放入腔内,并执行洗腔程序,按照刻蚀时间设定洗腔时间。在工艺本上登记刻蚀参数并清理台面。
(5)平台特殊气体(易燃气体:甲烷,硅烷,氢气;毒腐气体:氨气,氯气,一氧化二氮,三氯化硼)由于尾气处理设备启动需要加热和冷却时间较长,因此一般仅限于上班时间使用。请使用上述气体的学生合理安排工艺时间。
推荐书籍(图书馆可借阅)
1 微纳米加工技术及其应用